Cleaning이란?
공정을 방해하는 웨이퍼의 오염물이나 외무 물질등에 의해 생긴 방해요소들을 제거하여 공정의 퀄리티를 높이기 위해 웨이퍼를 깨끗하게 하는 것
Cleaning으로 처리하는 요소들
- Particles: 장비, 카스, DI water, 화학물질 등에서 생성되는 외부 입자들 -> 패턴을 생성하는데 방해, 칩 쇼트 or 오픈 발생
- Metal: 장비, 화학물질, etching 등에서 발생 -> 절연성능저하, 누전 발생
- Organic(CxHx): PR의 잔여물, 사람등에서 발생 -> Oxide의 절연 저하
- Micro-Roughness: 화학물질 등에 의해 웨이퍼의 표면이 거칠게 됨 -> 웨이퍼 표면의 Carrier Mobility 특성 저하, Break down 특성 저하.
- Native oxide: 주변습기, DI water 등에 의한 의도치 않은 산화 -> 퀄리티가 낮은 산화막이 생성됨
LEVEL 1 Contamination Reduction: Clean Room
오염물질이 없는 깨끗한 공정 환경을 위한 Clean Room을 조성
LEVEL 2 Contamination Reduction: Wafer Cleaning
Cleaning 용액 등으로 웨이퍼를 세척
Cleaning 용액의 종류
1) Piranha (과산화 황산 혼합물)
H2SO4 : H2O2 = 1~4 : 1
불순물 자체를 녹이는 용액

2) SC-1 (과산화암모니아 혼합물)
NH4OH : H2O2 : H2O = 1 : 1 : 5
웨이퍼의 표면산화시킨뒤, SIO2를 Etching 하여 유기물, 알칼리금속, Particle 등을 떨어뜨림
단점: 표면에 Micro-Roughness발생, 알칼리 금속이 다시 붙을 수 있음, Thin chemical oxide 형성


3) SC-2 (과산화염산 혼합물)
HCl : H2O2 : H2O = 1 : 1 : 5
메탈을 제거하는 Cleaning 용액
단점: SC-1의 잔여물인 NH4와 Cl이 결합해 불순물이 생길 수 있음, 산화(부식)성이 높음,
Thin chemical oxide 생성

4) DHF (희석된 HF)
HF : H2O = 1 : 10 to 100
Cleaning 후 Si가 산화된 SiO2를 제거함으로 웨이퍼의 표면을 소수성으로 바꿈
(SiO2 -> 친수성, Si -> 소수성)
SiO2 + 6HF -> H2SiF6 + 2H2O
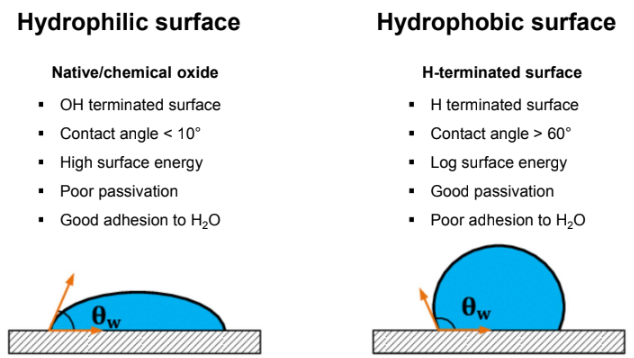
왼쪽이 친수성, 오른쪽이 소수성
5) BOE
HF : NH4F = 1 : 6
SiO2를 제거
클리닝 과정
- Standard Cleaning
Piranha -> Rinse(DI water로 세척) -> SC-1 -> Rinse -> SC-2 -> Rinse -> HF Cleaning -> Rinse
2. Informal cleaning
Piranha -> Rinse -> HF Cleaning -> Rinse
#취준 #취준생 #반도체공정 #반도체8대공정 #클리닝 #Clean #Cleaning #반도체 #공정 #세정 #웨이퍼세정 #세정공정
'반도체 공정' 카테고리의 다른 글
| [반도체 공정] Diffusion 확산공정 (0) | 2023.04.20 |
|---|---|
| [반도체 공정] Oxidation 산화 (0) | 2023.04.17 |

