반도체 공정에서 가장 광범위 하게 많이 사용되는 SiO2를 생성하는 공정.
- SiO2의 특성
1) 에너지 밴드의 갭이 큰 절연막이다.
2) 고전압 에서도 버틸 수 있다.
3) Si가 돌출되어 있어도 conformal하게 growth 가능하다.
4) 선택적 etch가 쉽다.
5) Mask 역할이 가능하다.
2. Oxide의 종류
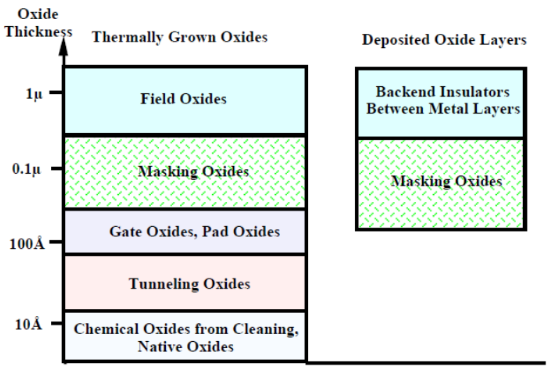
Field Oxide: 소자와 소자 사이를 나눠주는 Oxide
Masking Oxides: 도핑 등을 할때 원하는 부분만 도핑이 되도록 Masking 해주는 Oxide
Gate oxide: MOSFET 소자에서 Source-Gate-Drain간 절연시키기 위해 사용되는 Oxide
Tunneling Oxides: 의도적으로 Tunneling 발생이 필요한 부분에 사용하는 Oxide (ex. 메모리)
Chemical Oxides from Cleaning: 의도치 않게 발생한 Oxide
3. Oxide의 두깨측정

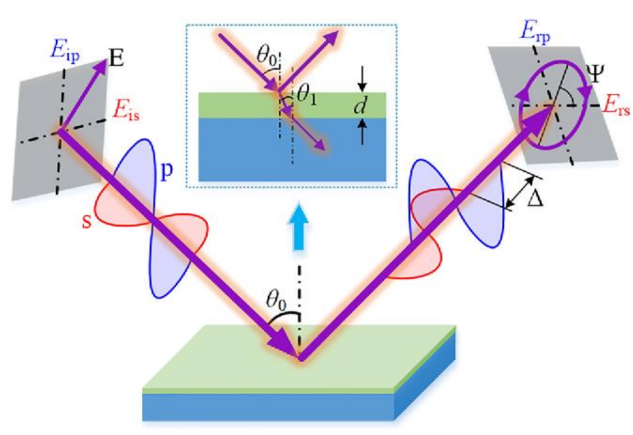
다음과 같은 장비로 빛을 쏴 편광정보를 이용하여 두깨를 측정한다.
4. Furnace Type
1) Horizontal tube furnace

가로로 웨이퍼를 배치하여 Oxidation 실행한다.
장점: Vertical 대비 싸고 간단하다.
단점: 제대로 Oxidation이 안되는 Foot Print가 생긴다.
2) Vertical tuve furnace
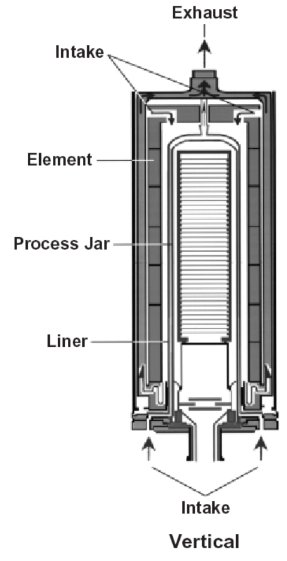
세로로 웨이퍼를 배치하여 Oxidation을 진행한다.
장점: Footprint가 적다, Uniformity하다.
단점: 가격이 비싸다.
5. Oxidation의 Basic Process
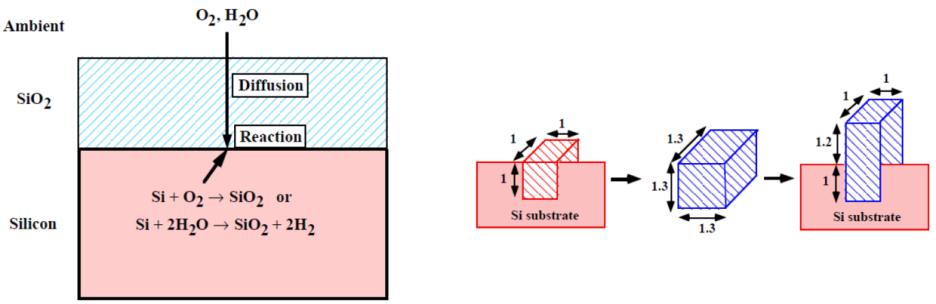
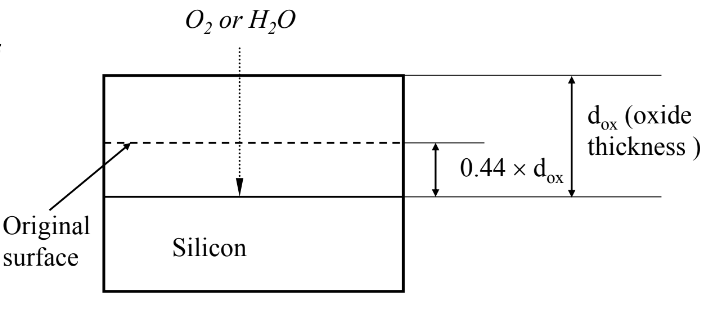
SiO2는 웨이퍼의 Si와 외부의 O2 또는 H2O가 반응하여 생성된다. 이때 그림처럼 부피가 팽창하게 된다.
표면에서 안쪽으로 생성이 되므로 제일 표면에 있는 SiO2는 가장 처음에 생성된 SiO2이다.
6. Oxidation의 종류
1) Dry Oxidation
O2를 이용한 Oxidation
Si(solid)+O2 -> SiO2(solid)
2) Wet Oxidation
H2O를 이용한 Oxidation
Si(solid)+2H2O(steam, or water vapor) -> SiO2(solid)+2H2
7. Dry 와 Wet 의 차이
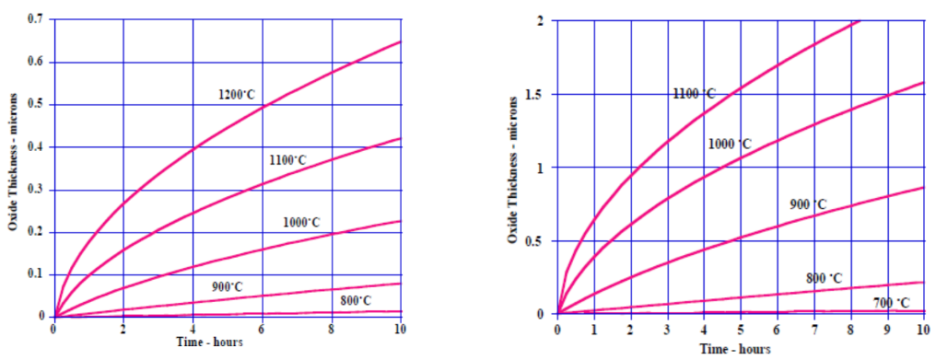
1) 성장속도 Dry < Wet
성장 속도에 있어서는 실리콘 SiO2 내의 수증기(H20)의 용해도가 산소(O2)보다 103배 더 좋기 때문에
SiO2 표면에 도달하는 양이 많아 더 빠르게 산화 막을 성장시킨다.
2) 품질 Dry > Wet
성장속도가 느린 Dry가 상대적으로 막의 두깨를 조절하기 쉽고, 전기적 특성이 좋다. Wet oxidation은 산화 막에 잔류하는 수소가 Bubble을 생성하면서 SiO2의 밀도가 떨어지고 퀄리티가 안좋게 된다.
8. Deal-Grove Model
SiO2의 두께에 따라 산화막이 생성되는 속도가 달라지는 것을 해석한 모델
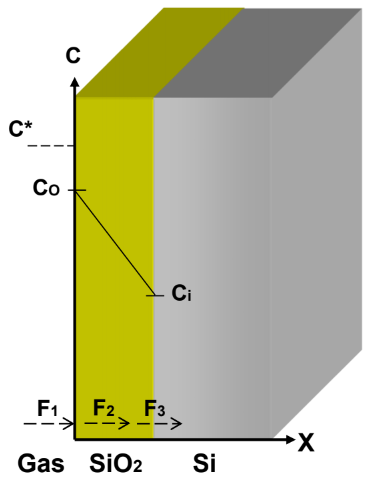

Ci = Si와 SiO2계면에서의 산화제농도 F1= 가스 챔버 내의 산화제의 유속
Co= SiO2 표면의 산화제농도 F2= SiO2 내의 산화제의 유속
C*= 가스 챔버 내의 산화제농도 F3= SiO2/Si 계면을 통과하는 산화제의 유속
dox largh (SiO2가 매우 두꺼울 때)는 다음과 같다.
Ci= 0, Co= C*
dox small (SiO2가 매우 얇을 때)는 다음과 같다.
Ci= Co= \combi{C}^{\cdot }\to \frac{\combi{C}^{\cdot }}{1+\frac{\combi{k}_s}{h}}
Oxidation rate

위 식을 미분 방정식으로 풀게 되면 다음과 같은 결과가 나온다.


위 식을 마지막으로 정리하면 아래와 같은 식이 된다.

이때 Short time oxidation (t+τ << A2/4B)일때와 Long time oxidation (t>>τ) 일 경우의 식은 다음과 같다.

Short time oxidation


9. 실리콘 종류에 따른 Oxidation 차이

반응속도: (100) < (111) (C*111 > C*100 이기 때문에)
oxide 퀄리티: (100) > (111)
10. Defrcts of SiO2
1) Fixed chargc (Qf)
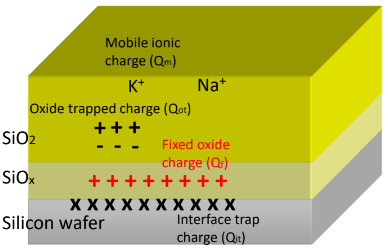

-불완전한 결합으로 인해 SiO2와 Si 사이에 SiOx가 생성됨. (1< x <2)
-(100)보다 (111)에서 더 많이 발생
-Positive charge
해결방법: 빠른 쿨링, 공정이 끝난 뒤 inert gas(Ar 등) 을 채우고 Annealing
2) Interface trap charge (Qit)
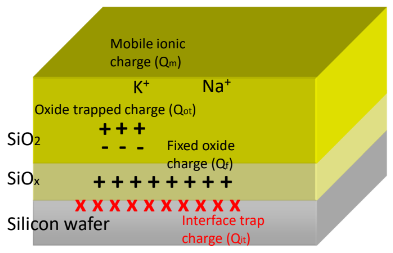
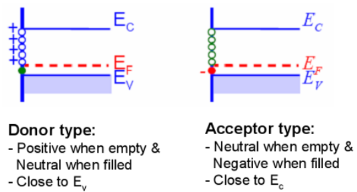
-Energe Band 사이에 전자가 존재할 수 있는 trap이 생김
-Vth가 불안정 하게 됨
해결방법: 저온 PMA(Post Metallization Annealing)
3) Oxide trap charge (Qot)
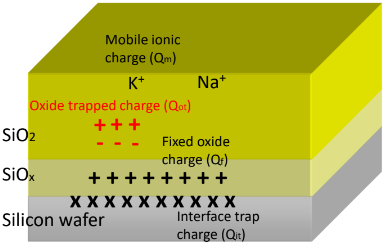
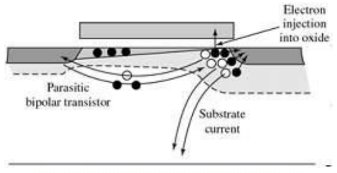
-SiO2 내부에 존재
-공정에서 강력한 에너지로 인해 Si-O의 결합이 깨지며 Oxide내부에 전자가 생김
해결방법: Annealing
4) Mobile Ionic Charge (Qm)
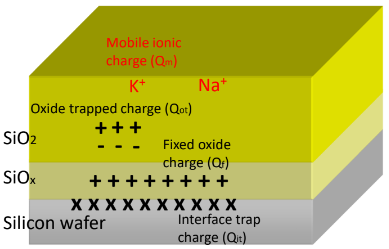
-Oxide 내 어디서나 존재
-공정 중 사람에 의한 불순물, 알칼리 이온, 금속 등으로 인해 발생
-Vt를 낮춤
#취준 #취준생 #반도체공정 #반도체8대공정 #산화과정 #산화 #Oxidation #Oxide #반도체 #공정
'반도체 공정' 카테고리의 다른 글
| [반도체 공정] Diffusion 확산공정 (0) | 2023.04.20 |
|---|---|
| [반도체 공정] Cleaning 클리닝 (0) | 2023.04.15 |

